





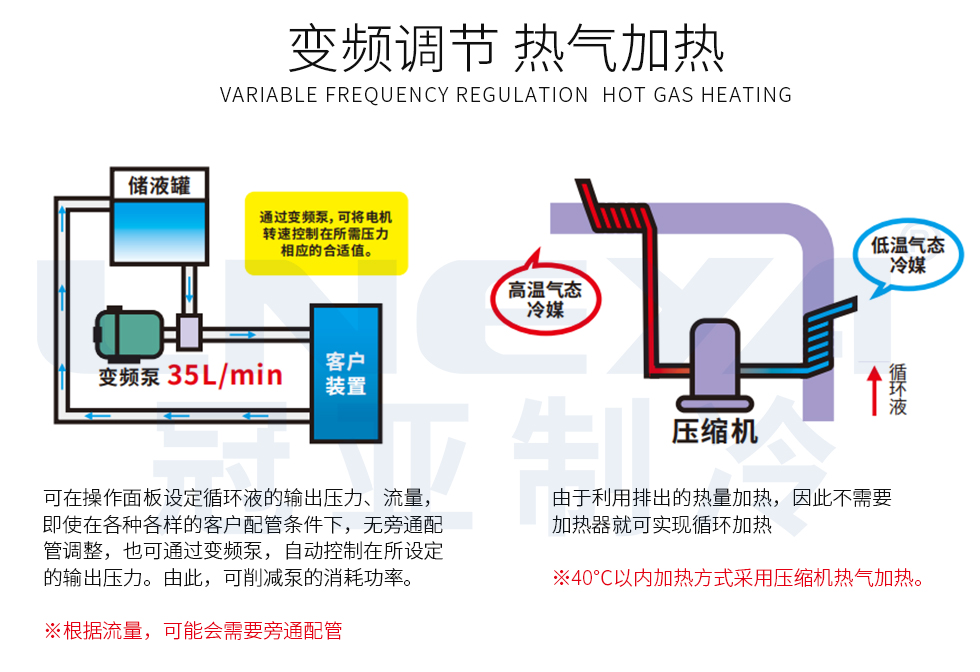

隨著(zhù)芯片封裝工藝正面臨著(zhù)熱管理挑戰,芯片氣體沖擊熱流儀憑借其高速氣流循環(huán)提供可控冷熱源,不僅是溫控技術(shù)的升級,更是半導體封裝工藝向智能化、低缺陷制造轉型的機遇之一,都為半導體產(chǎn)業(yè)續寫(xiě)新篇。
一、半導體封裝工藝對準確控溫的核心需求
半導體封裝涉及塑封、回流焊、熱壓鍵合、老化測試等關(guān)鍵工序,溫度控制的精度直接影響封裝質(zhì)量與產(chǎn)品可靠性:
1. 材料特性敏感:環(huán)氧樹(shù)脂、焊料等材料對溫度波動(dòng)敏感,±1℃偏差可能導致分層、空洞或翹曲缺陷。
2. 工藝效率要求:封裝周期需快速升溫/降溫以減少熱應力,同時(shí)避免溫度梯度導致的晶圓變形。
3. 可靠性驗證:老化測試需模擬嚴苛溫度(-55℃~150℃)循環(huán),驗證芯片長(cháng)期穩定性。
二、芯片氣體沖擊熱流儀的準確控溫技術(shù)方案
1. 技術(shù)原理與核心設計
芯片氣體沖擊熱流儀通過(guò)高速氣體流動(dòng)與準確熱交換技術(shù)實(shí)現動(dòng)態(tài)溫控,其核心技術(shù)包括:
PID+模糊控制算法:實(shí)時(shí)監測溫度波動(dòng),動(dòng)態(tài)調節氣體流速與加熱功率,控溫精度達±0.1℃。
流體動(dòng)力學(xué)設計:優(yōu)化噴嘴布局與氣流路徑,確保晶圓表面溫度均勻性。
多級制冷系統:集成雙制冷源,實(shí)現-55℃~200℃寬溫域快速切換。
2. 芯片氣體沖擊熱流儀應用場(chǎng)景與解決方案
場(chǎng)景1:塑封工藝
問(wèn)題:環(huán)氧樹(shù)脂固化時(shí)溫度不均導致內部應力,引發(fā)分層或裂紋。
方案:熱流儀通過(guò)高溫度沖擊,較短時(shí)間內將模具溫度均勻升,固化時(shí)間縮短,缺陷率降低。
場(chǎng)景2:老化測試
問(wèn)題:傳統溫箱溫變速率慢,測試周期長(cháng)。
方案:熱流儀以速率循環(huán)切換-55℃~125℃,循環(huán)測試時(shí)間縮短,數據誤差小。

多通道獨?控溫,可以具備單獨的溫度范圍、冷卻加熱能?、導熱介質(zhì)流量等,根據所需的溫度范圍選擇采?蒸汽壓縮制冷,或者采?ETCU?壓縮機換熱系統,系統可通?膨脹罐、冷凝器、冷卻?系統等,可以有效減少設備尺?,減少操作步驟。



智藥研習社官方微信

制藥在線(xiàn)官方微信
 2006-2025 上海博華國際展覽有限公司版權所有(保留一切權利)
滬ICP備05034851號-57
2006-2025 上海博華國際展覽有限公司版權所有(保留一切權利)
滬ICP備05034851號-57