





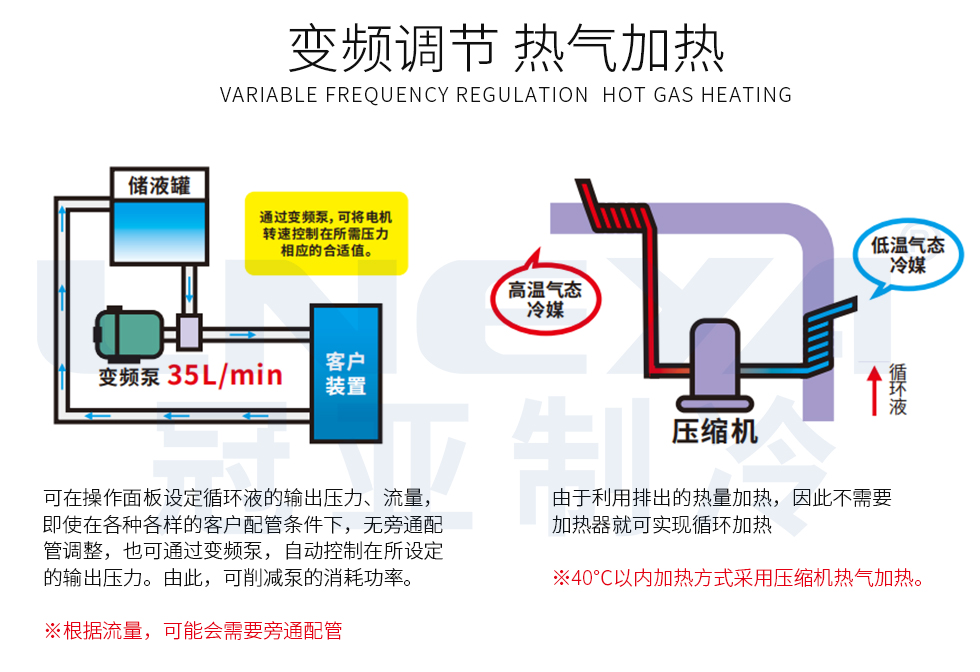

thermal 熱流儀在芯片可靠性測試中有著(zhù)一定的應用,能在多種測試場(chǎng)景發(fā)揮作用,同時(shí)具備多項優(yōu)勢,以下是具體介紹:
一、芯片可靠性測試的核心挑戰
隨著(zhù)芯片制程進(jìn)入3nm以下及封裝(如3D IC、Chiplet)技術(shù)的普及,芯片可靠性測試面臨更高要求:
嚴苛溫度耐受性:芯片需在-55℃~150℃范圍內穩定工作,且需承受快速溫變帶來(lái)的熱應力。
局部熱點(diǎn)風(fēng)險:高密度封裝下,功率芯片(如CPU、GPU)的局部溫度易引發(fā)電遷移或熱失效。
測試效率與成本:傳統溫箱測試周期長(cháng),難以滿(mǎn)足快速迭代需求。
二、Thermal熱流儀在芯片測試中的核心應用
1. 溫度循環(huán)測試(Temperature Cycling)
測試目標:驗證芯片在嚴苛溫度交替下的機械穩定性(如焊點(diǎn)疲勞、分層缺陷)。
技術(shù)方案:熱流儀以50℃/min速率循環(huán)切換-55℃~125℃,模擬芯片在汽車(chē)電子或工業(yè)環(huán)境下的壽命。
2. 高溫老化測試(Burn-in)
測試目標:篩選早期失效芯片,提升量產(chǎn)良率。
技術(shù)方案:熱流儀在125℃下對芯片施加額定電壓,,加速電遷移與氧化失效。
3. 熱阻測試(Thermal Resistance, Rth)
測試目標:量化芯片結溫(Tj)與環(huán)境溫度(Ta)的熱傳導效率。
技術(shù)方案:熱流儀結合紅外熱像儀與熱電偶,實(shí)時(shí)監測結溫并計算。
4. 熱沖擊測試(Thermal Shock)
測試目標:驗證芯片在溫變下的抗裂性(如陶瓷封裝、硅通孔TSV結構)。
技術(shù)方案:熱流儀加熱實(shí)現-75℃→150℃切換,模擬芯片在航天器進(jìn)出大氣層的嚴苛環(huán)境。

多通道獨?控溫,可以具備單獨的溫度范圍、冷卻加熱能?、導熱介質(zhì)流量等,根據所需的溫度范圍選擇采?蒸汽壓縮制冷,或者采?ETCU?壓縮機換熱系統,系統可通?膨脹罐、冷凝器、冷卻?系統等,可以有效減少設備尺?,減少操作步驟。



智藥研習社官方微信

制藥在線(xiàn)官方微信
 2006-2025 上海博華國際展覽有限公司版權所有(保留一切權利)
滬ICP備05034851號-57
2006-2025 上海博華國際展覽有限公司版權所有(保留一切權利)
滬ICP備05034851號-57